下一代 AI 与高性能计算先进封装的材料基础:300mm 碳化硅技术
人工智能 (AI) 工作负载的快速增加,正在从根本上重塑数据中心的架构,推动封装尺寸、功率密度和集成复杂度达到前所未有的水平。在持续的高工作负载条件下,传统封装材料受到其热学、机械和电气性能极限的制约。本文探讨了 Wolfspeed 的 300 mm 碳化硅 (SiC) 技术平台如何为下一代人工智能 (AI) 和高性能计算 (HPC) 异构封装架构提供可规模化的材料基础,从而在热管理、机械完整性和电气集成方面实现新的突破,并与行业制造基础设施对齐。
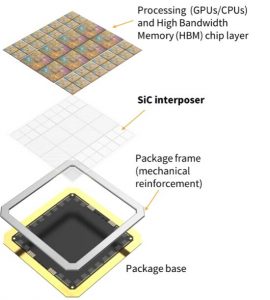
图 1. 采用碳化硅中介层的下一代高性能计算 (HPC) 异构封装的简化示意图(仅作说明用途)
1. 人工智能 (AI) 与高性能计算 (HPC) 的封装挑战
人工智能 (AI) 与高性能计算 (HPC) 的集成发展路线要求封装解决方案的尺寸增大至三倍,集成更多样化的功能,并支持高达五倍的功率耗散。这些趋势正将现有封装架构推向可用材料的极限,导致热梯度、机械可靠性风险以及功率传输效率低下等问题,而这些问题使用传统的硅或有机基板难以解决。
2. 为什么碳化硅是答案
单晶碳化硅独特地结合了其他任何可规模化半导体基板所不具备的材料特性:
- 热性能:热导率为 370 – 490 W/m·K,是硅的三倍,可实现优异的横向和纵向热扩散。
- 机械稳健性:高硬度、高强度和高热稳定性支持大面积多芯片芯粒 (chiplet) 组装和高带宽内存 (HBM) 堆叠。
- 电气性能:高电阻率和介电强度可实现更高的布线密度、低损耗信号传输,并简化功率传输和隔离结构的集成。
这些特性的融合使得在单个可扩展封装材料平台内,能够在热学、机械和电气领域实现性能的协同提升。
3. 为什么 300 mm 至关重要
向 300 mm 碳化硅晶圆尺寸的转型,使先进封装材料与前沿的半导体制造和晶圆级封装工艺保持一致,并充分利用了现有的行业工具和基础设施。这不仅实现了可重复、大规模生产的可制造性,同时也支持成本优化和生态系统兼容性。
此外,300 mm 平台使得制造更大的中介层和热扩散组件成为可能,从而支持行业向日益增大的封装尺寸和更复杂的异构集成方向发展。
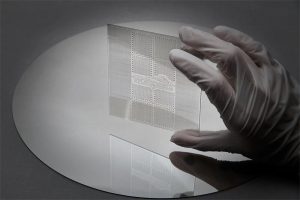
图 2. 由 Wolfspeed 300 mm 碳化硅晶圆实现的100mm x 100mm 大型中介层基板的概念演示
4. 先进封装创新的更大价值
Wolfspeed 的碳化硅平台在封装堆叠的多个层面都创造了价值:
- 碳化硅热扩散组件能够实现多向热传导,增加有效冷却面积并缓解局部热点。
- 碳化硅基中介层增强了横向和纵向热扩散,解决了人工智能 (AI) 持续工作负载下的散热瓶颈问题。
新兴的异构集成趋势进一步放大了碳化硅在系统层面的影响:
- 直接芯片(Direct-to-chip, D2C)液体冷却:允许设计工程化的表面结构,以改善芯片到冷却剂的热传递。
- 封装内功率传输(In-package power delivery, IPPD):支持集成功率传输和隔离结构,缩短功率传输路径并改善电压调节。
5. 展望未来
随着行业朝更高功率计算解决方案迈进,Wolfspeed 300 mm 碳化硅平台为下一代人工智能 (AI) 和高性能计算 (HPC) 系统提供了可靠的基础。通过与正在合作的伙伴评估计划,Wolfspeed 与生态系统合作伙伴及研究机构紧密协作,共同评估技术可行性、性能优势、可靠性以及集成路径。这种协作方式旨在加速学习进程,降低采用风险,并帮助行业为未来人工智能 (AI) 工作负载所需的碳化硅-硅混合封装架构做好准备。